长电科技股份有限公司(绍兴长电科技股份有限公司)
日期:2023年07月09日 01:10 浏览量:1
【爱集微点评】长电科技的SIP封装专利,通过在转接板下表面的导电焊盘阵列与转接板边缘轮廓之间的转接板下表面部分区域设置凹槽,能够避免在塑封过程中塑封料溢到转接板下表面的导电焊盘区域,防止塑封料污染转接板下表面的导电焊盘区域。
集微网消息,近日,长电科技股东大会顺利召开,作为国内封装测试的领先企业,近年来长电科技一直在系统级(SiP)封装等领域持续发力。
随着半导体技术的不断发展,为了满足越来越多的应用需求,电子封装体正朝着小型化、微型化发展,因此系统级封装技术(SiP)越来越受重视。双面SiP封装中,基板一侧面同时设置有芯片和锡球结构,一般情况下会使用转接板来解决芯片与融化后的锡球之间产生的高度差问题,同时增加封装结构的可靠性、散热性和布球范围,然而这也会导致转接板悬空在被动元件等一些元件高度允许的区域上方。此种封装方法在转接板一侧进行注塑过程中容易出现溢胶等情况,且在注塑过程中固定的塑封模套存在将转接板往基板一侧压低,甚至将转接板压到被动元件上表面的风险。。
为此,长电科技于2022年10月13日申请了一项名为“双面SiP封装结构及其制作方法”的发明专利(申请号:202211251028.3),申请人为江苏长电科技股份有限公司。
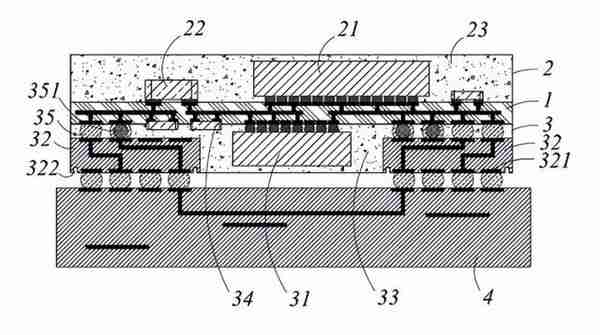
图1双面SiP封装结构示意图(一块芯片)
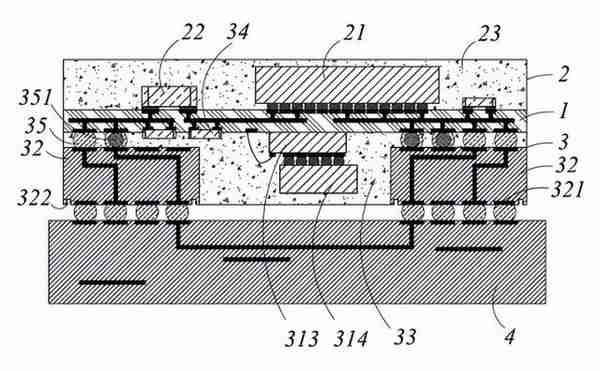
图2 双面SiP封装结构示意图(两块芯片混合贴装结构)
图1图2分别为本专利提出的一种双面SiP封装结构示意图(一块芯片、两块芯片混合贴装结构),包括基板1、设置于基板1上下表面的第一封装结构2和第二封装结构3。其中基板1上表面和下表面具有多个电性焊盘,第一封装结构2包括一块倒装焊接于基板1上表面的半导体元件21和两块设置于基板1上表面的被动元件22、以及设置于基板1上表面并覆盖半导体元件21和被动元件22的塑封体23。
第二封装结构3包括两块芯片31,两块芯片31分别为设置于基板1下表面的第一芯片313和设置于第一芯片313下表面的第二芯片314,形成混合芯片贴装结构。参见图2,在基板1下表面先贴装第一芯片313,第一芯片313通过金线键合的方式与基板1实现电性连接,然后再将第二芯片314的功能面朝向第一芯片313下表面,通过金属球焊将第二芯片314倒装焊接于第一芯片313功能面,实现第一芯片313、第二芯片314及基板1之间的电性连接。由于贴装于基板1下表面的芯片贴装结构整体厚度增加,相应后续用于贴装在基板1下表面的转接板32的厚度可作对应调整,使得转接板32的下表面在高度方向上不高于第二芯片314下表面即可。
另外,转接板32上表面设置导电结构件阵列35,导电结构件阵列35为锡球组成的阵列,部分锡球内设置有结构支撑件351,结构支撑件351为铜核球,通过铜核球配合基板1和转接板32内部用于电路导通的铜柱,可以对射频信号起到一定的屏蔽效果,保护芯片31或焊接于基板1下表面的其他器件不受其他射频信号的干扰。

图3 双面SiP封装结构的制作方法流程示意图
图3 为双面SiP封装结构的制作方法流程示意图,首先需要提供一基板,基板包括多个基板待切割单元1’,并于每个基板待切割单元1’上表面形成第一封装结构2(步骤S1)。接着提供多块芯片31,将其功能面通过球焊焊接于每个基板待切割单元1’下表面(步骤S2)。然后提供包括多个转接板切割单元32’的待切割转接板,每个转接板切割单元32’下表面设置有导电焊盘阵列321,于导电焊盘阵列321与转接板切割单元32’边缘轮廓之间的部分区域形成一凹槽322(步骤S3)。在每个转接板切割单元32’上表面制作形成导电结构件阵列35,将待切割转接板上表面通过导电结构件阵列35’焊接于基板1下方部分区域(步骤S4)。最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(步骤S5)。
简而言之,长电科技的SIP封装专利,通过在转接板下表面的导电焊盘阵列与转接板边缘轮廓之间的转接板下表面部分区域设置凹槽,能够避免在塑封过程中塑封料溢到转接板下表面的导电焊盘区域,防止塑封料污染转接板下表面的导电焊盘区域。
长电科技一直是半导体封装领域的领先企业,公司以领先的技术和高品质的产品赢得了客户的信赖与认可。公司在SIP等封装技术上不断精益求精,为客户带来了优质的解决方案。长电科技凭借着半导体封装领域的技术实力,在市场竞争中占据了一席之地,助力客户在行业中再创辉煌。
推荐阅读

-
红枣会(红枣会过敏吗)
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...

-
北京市如何计算缴纳社保基数(北京社保基数计算公式)
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...

-
泸州宝光药业集团有限公司(泸州市宝光药业有限公司)
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...

-
中国元宇宙(元宇宙在中国开辟全新领域)
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...

-
15年8月份上海公司牌照
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...

-
中国建设银行苏州分行(中国建设银行苏州分行待遇)
2023-07-09
最后,将塑封料填充基板1下表面、芯片31与待切割转接板之间的空间区域,在每个基板待切割单元1’下表面形成第二封装结构3(...
